 PDF(22298 KB)
PDF(22298 KB)


3D 封装中硅通孔的电–热–结构耦合分析
张远乐, 龚瑜璠, 陈召川, 赵起, 孟欣, 李强, 陈雪梅
工程热物理学报 ›› 2024, Vol. 45 ›› Issue (11) : 3508-3516.
 PDF(22298 KB)
PDF(22298 KB)
 PDF(22298 KB)
PDF(22298 KB)
3D 封装中硅通孔的电–热–结构耦合分析
Electrical-thermal-structural Coupling Analysis of Through Silicon Vias in 3D Packaging
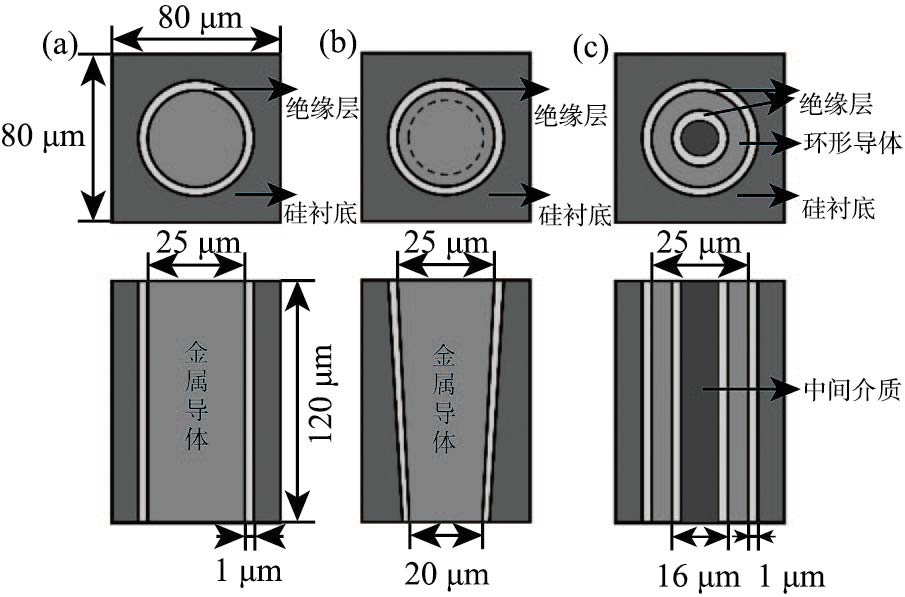
| {{custom_ref.label}} |
{{custom_citation.content}}
{{custom_citation.annotation}}
|
/
| 〈 |
|
〉 |